陶瓷基板的封装工艺与应用
2026-01-08 16:51:06
陶瓷基板,又称陶瓷电路板,主要由陶瓷基片与表面金属线路层组成。在电子封装中,封装基板承担着承上启下、连接内外散热路径的关键作用,兼具电气互连、机械支撑及散热等重要功能。陶瓷材料因其热导率高、耐热性好、机械强度优越、热膨胀系数低等特点,成为功率半导体器件封装中的常用基板材料。根据封装结构及应用需求,陶瓷基板主要可分为平面陶瓷基板和三维陶瓷基板两大类。
一、平面陶瓷基板
根据制备原理与工艺不同,平面陶瓷基板主要分为以下几类:

薄膜陶瓷基板 (TFC)产品

TPC基板制备工艺流程图
1. 薄膜陶瓷基板(TFC)
采用溅射工艺在陶瓷基片表面直接沉积金属层,并可通过光刻、显影、刻蚀等工艺将金属层图形化为线路。由于溅射沉积速率低(通常低于1 μm/h),TFC基板的金属层较薄(一般小于1 μm),可实现高图形精度(线宽/线距小于10 μm),主要应用于激光与光通信等领域的小电流器件封装。
2. 厚膜印刷陶瓷基板(TPC)
通过丝网印刷将金属浆料涂覆于陶瓷基片上,经干燥和高温烧结(850°C–900°C)形成线路。金属层厚度通常为10–20 μm,可通过多次印刷增加厚度。TPC基板工艺简单、成本低,但受丝网印刷限制,线路精度较低(最小线宽/线距一般大于100 μm),且金属浆料中添加的玻璃相会降低其电导率和热导率,因此多用于汽车电子等对线路精度要求不高的领域。
TPC基板关键技术在于金属浆料:浆料一般由金属粉末、有机载体和玻璃粉组成。银基导电浆料因导电导热性能好、成本较低而占据主流。研究表明,银颗粒的粒径、形貌等对导电性能有显著影响。有机载体决定浆料的流变特性,影响印刷质量和烧结后的致密性。玻璃粉的加入可降低烧结温度,目前环保型无铅玻璃粉是研发重点。
3. 直接键合陶瓷基板(DBC)
在铜箔与陶瓷基片(如Al₂O₃、AlN)之间引入氧元素,在高温(约1065°C)下形成Cu/O共晶相,进而与陶瓷反应生成化合物,实现铜箔与陶瓷的共晶键合。DBC基板导热性好、键合强度高、热稳定性优异,铜箔厚度通常为100–600 μm,适用于IGBT、激光器、聚焦光伏等大电流、高温工作环境。但其工艺对温度与氧含量控制要求严格,生产成本较高,且由于厚铜刻蚀限制,难以实现高精度线路。

DBC陶瓷基板产品

DBC陶瓷基板制备工艺流程
4. 活性金属焊接陶瓷基板(AMB)
在铜箔与陶瓷之间加入活性金属钎料(如Ag-Cu-Ti),在真空高温下实现焊接。AMB基板结合强度高,热循环性能好,尤其适用于对可靠性要求严苛的车载功率模块等领域。
5. 直接电镀陶瓷基板(DPC)
采用激光打孔、图形化掩膜、电镀等工艺在陶瓷表面形成铜线路。DPC基板线路精度高、可垂直互联,适用于高密度封装,但金属层厚度有限,一般适用于中小功率器件。
6. 激光活化金属陶瓷基板(LAM)
利用激光在陶瓷表面进行活化处理,再通过化学镀或电镀形成金属线路。该工艺适合局部金属化与精细线路制作,具有较好的设计灵活性。
二、三维陶瓷基板制备技术
三维陶瓷基板在平面基板基础上增加了立体结构,如腔体、台阶等,以满足更复杂的封装需求。常见类型包括:
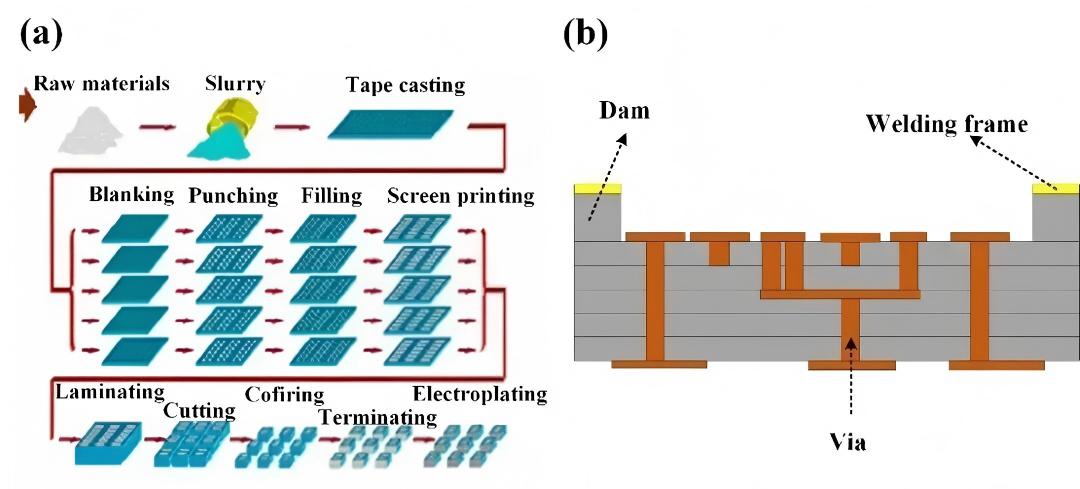
(a)HTCC陶瓷基板制备工艺流程和 (b)结构示意图
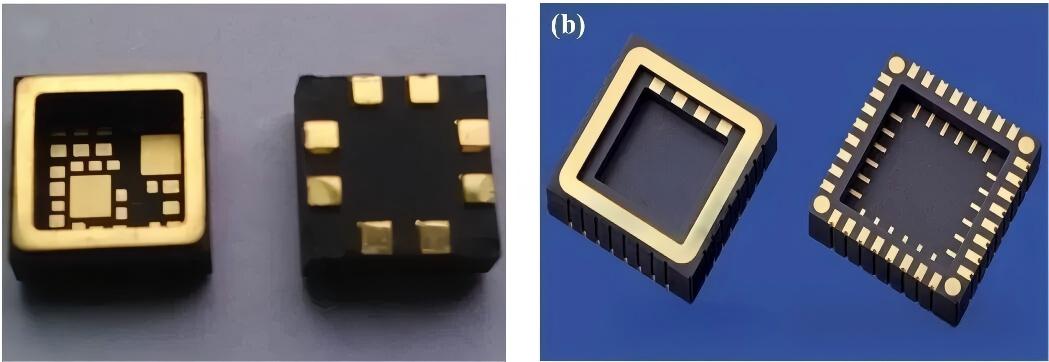
(a)HTCC陶瓷基板产品和 (b)LTCC陶瓷基板产品
1. 高/低温共烧陶瓷基板(HTCC/LTCC)
HTCC:采用高温烧结(约1600°C),陶瓷生胚与钨、钼等高熔点金属浆料共烧。具有机械强度高、热导率好、稳定性高等优点,但金属导电性较差、成本高。
LTCC:在陶瓷中添加玻璃粉以降低烧结温度(通常850–900°C),可使用银、铜等导电性好的金属浆料。具有工艺温度低、介电性能可调、适合多层布线等特点,广泛应用于高频、高可靠性领域,如航天、军工电子。
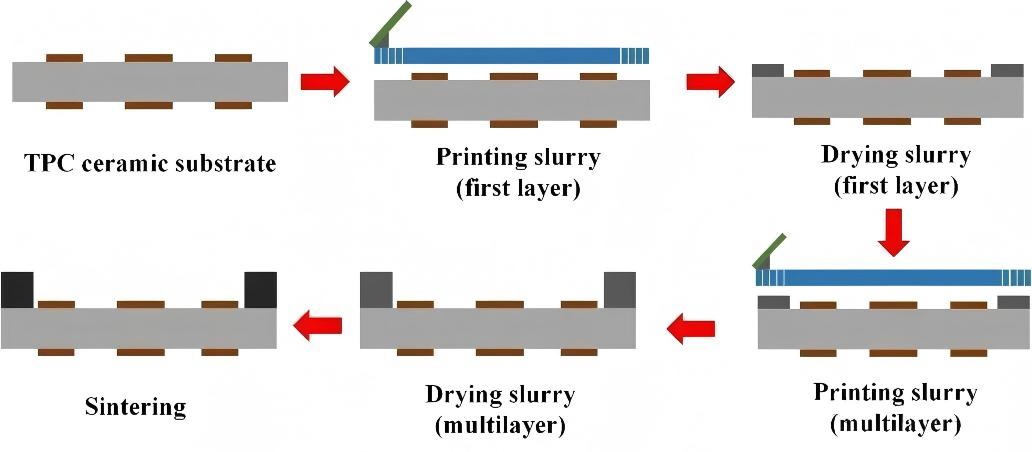
MSC陶瓷基板制备工艺流程

MSC三维陶瓷基板产品
2. 多层烧结三维陶瓷基板(MSC)
在平面TPC基板上通过多次丝网印刷陶瓷浆料并烧结,形成腔体结构。其优点是工艺简单、热膨胀匹配性好,但受丝网印刷限制,腔体厚度和线路精度有限,适用于对精度要求不高的小型器件封装。
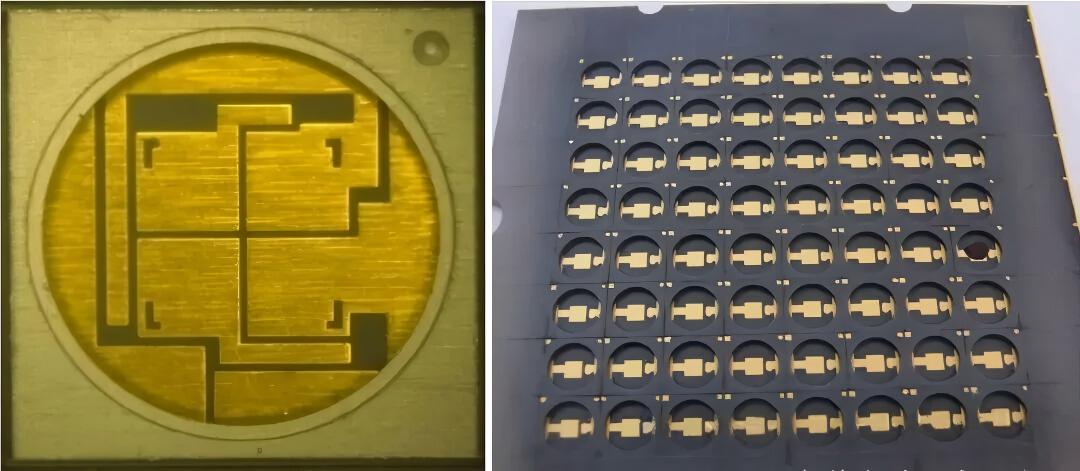
有机胶接法制备DAC陶瓷基板产品
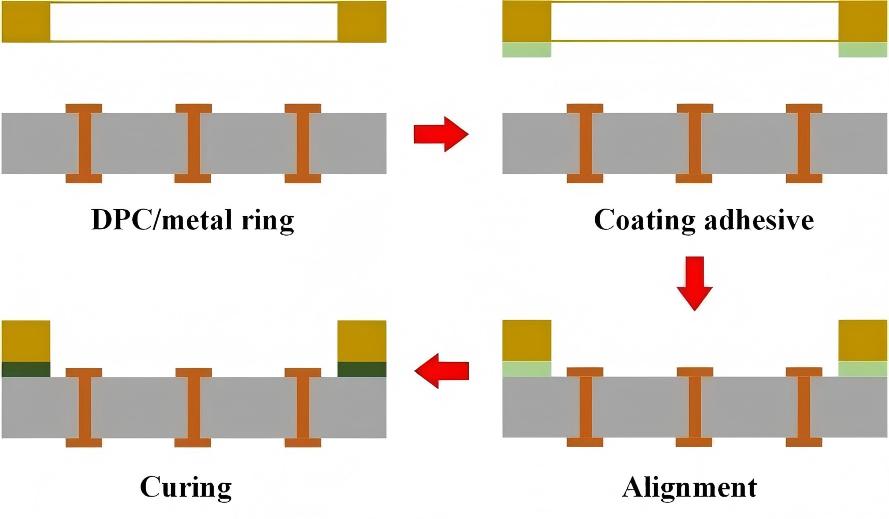
DAC三维陶瓷基板制备工艺流程
3. 直接粘接三维陶瓷基板(DAC)
将金属或陶瓷环通过有机胶粘剂与高精度DPC基板在低温下粘接成型。该工艺简单、成本低,且不损伤DPC线路层,但有机胶耐热性、气密性较差,适用于对散热与密封要求不高的高精度器件封装。
4. 多层镀铜三维陶瓷基板(MPC)
通过多次图形化电镀在陶瓷基板上构建三维铜结构,可实现高精度、高导热的立体线路,但工艺步骤较为复杂。
5. 直接成型三维陶瓷基板(DMC)
采用注塑或压铸工艺一次成型具有三维结构的陶瓷基板,再通过金属化处理形成线路,适合大批量、结构复杂的产品,但模具成本高,精度受成型工艺限制。
总结
陶瓷基板技术根据应用场景的不同,在材料选择、工艺方法和性能侧重上呈现出多样化发展。平面陶瓷基板以TFC、TPC、DBC、AMB等为代表,分别满足高精度、低成本、高功率等不同需求;三维陶瓷基板则通过HTCC/LTCC、MSC、DAC等工艺,在结构集成与功能扩展方面提供了更多可能。未来随着功率电子、射频模块、光电集成等领域的发展,陶瓷基板将继续向更高导热、更高精度、更高可靠性及更优成本的方向演进。
 0
0

